관련종목▶
로직 칩과 4개의 HBM 칩을 1개 패키지로 구현한 'I-Cube4' 개발
향후 "HBM 칩 6개, 8개 신기술도 선보이겠다"
향후 "HBM 칩 6개, 8개 신기술도 선보이겠다"
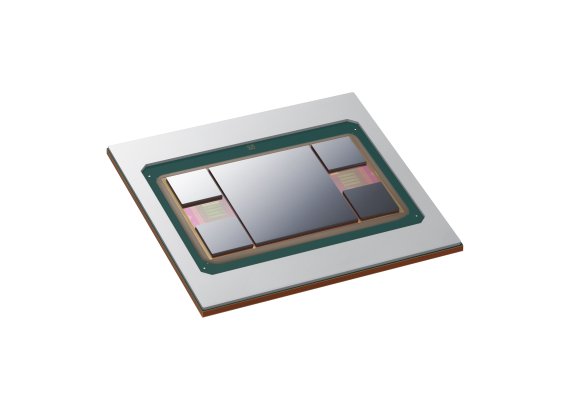
[파이낸셜뉴스] 삼성전자가 로직 칩과 4개의 고대역폭 메모리(HBM) 칩을 하나의 패키지로 구현한 2.5D 패키지 기술인 'I-Cube4'를 개발했다고 6일 밝혔다.
I-Cube4는 고대역폭 데이터 전송과 고성능 시스템 반도체를 요구하는 고성능컴퓨팅(HPC), 인공지능(AI)·클라우드 서비스, 데이터센터 등을 중심으로 폭넓게 활용될 것으로 기대된다.
I-Cube는 실리콘 인터포저 위에 중앙처리장치(CPU), 그래픽처리장치(GPU) 등의 로직과 HBM을 배치해 하나의 반도체처럼 동작하도록 하는 이종 집적화 패키지 기술이다. 이를 통해 전송 속도는 높이고, 패키지 면적은 줄일 수 있다.
인터포저란 칩과 기판(PCB) 사이에 추가로 삽입하는 미세회로 기판으로, 둘을 연결하면서 회로 폭 차이를 완충시키는 역할을 한다. PCB는 고성능 칩과 입출력 단자의 밀도가 약 20배 차이나기 때문에 인터포저가 필요하다. 삼성전자는 I-Cube4에 실리콘 인터포저를 적용해 초미세 배선을 구현하고 반도체 구동에 필요한 전력도 안정적으로 공급할 수 있도록 했다. 보통 패키지 안에 탑재하는 반도체 칩이 많아질수록 인터포저의 면적도 함께 증가해 공정상의 어려움도 커진다.
삼성전자는 100㎛(1㎛=100만분의 1m) 수준의 매우 얇은 인터포저가 변형되지 않도록 재료, 두께 등 다양한 측면에서 반도체 공정·제조 노하우를 적용했다.
또 I-Cube4에 몰드(칩을 감싸는 소재)를 사용하지 않는 독자적인 구조를 적용해 열을 효율적으로 방출하도록 했다.
삼성전자는 패키지 공정 중간 단계에서 동작 테스트를 진행해 불량을 사전에 걸러내고, 전체 공정 단계를 줄여 생산 기간을 단축했다.
강문수 삼성전자 파운드리사업부 마켓전략팀 전무는 "HPC 분야를 중심으로 차세대 패키지 기술의 중요성이 높아지고 있다"며 "I-Cube2 양산 경험과 차별화된 I-Cube4 상용화 기술 경쟁력을 기반으로 HBM을 6개, 8개 탑재하는 신기술도 시장에 선보이겠다"고 강조했다.
삼성전자는 지난 2018년 로직과 2개의 HBM을 집적한 I-Cube2 솔루션을 선보였고, 지난해에는 로직과 S램을 수직 적층한 X-Cube 기술을 공개한 바 있다.

km@fnnews.com 김경민 기자
※ 저작권자 ⓒ 파이낸셜뉴스, 무단전재-재배포 금지