업계 최대 용량 36GB 최초 개발
8단 대비 성능·용량 50% 이상 향상
SK하이닉스·마이크론 ‘3파전’ 가열
생산능력 앞세워 점유율 확대 기대
8단 대비 성능·용량 50% 이상 향상
SK하이닉스·마이크론 ‘3파전’ 가열
생산능력 앞세워 점유율 확대 기대
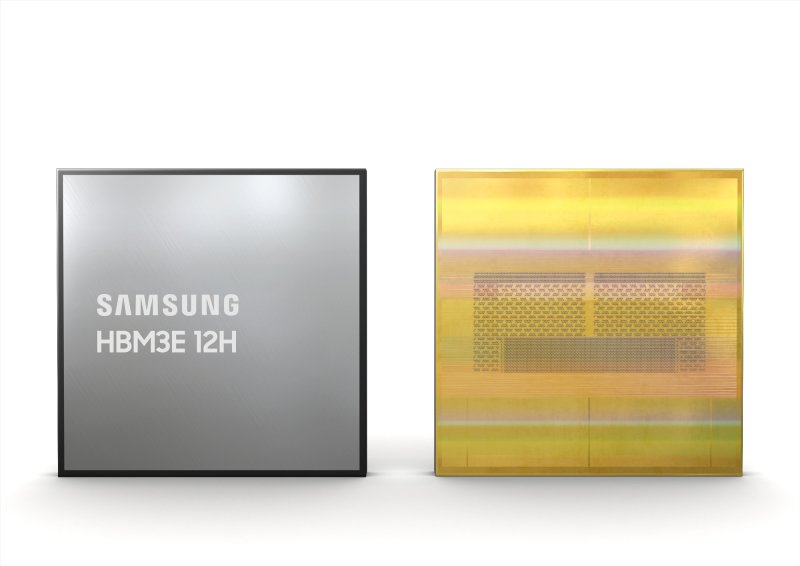
■ 업계 최대 용량 HBM3E 첫 개발
삼성전자는 27일 24Gb D램 칩을 실리콘관통전극(TSV) 기술로 12단까지 적층한 HBM3E 12H를 개발했다고 밝혔다.
이 제품은 초당 최대 1280GB의 대역폭과 업계 최대 용량인 36GB를 제공한다. 1초에 30GB 용량의 초고화질 울트라HD 영화 40여편을 다운로드 할 수 있는 속도다. 성능과 용량 모두 전작인 HBM3 8H 대비 50% 이상 향상됐다.
HBM은 개별 D램을 수직으로 쌓아 데이터 처리 속도와 전력 효율을 높인 제품이다. D램을 높이 쌓을수록 HBM 두께가 커져 발열 제어가 어려워진다는 점은 극복해야 할 과제였다. 칩 두께가 얇아져 물리적으로 휘어지는 것도 문제였다. 이를 해결하기 위해 삼성전자가 채택한 기술이 열압착 비전도성접착필름(Advanced TC NCF)이다. D램 사이에 비전도성접착필름을 넣어 HBM을 결합하는 방식이다. 이 기술을 적용하면 휘어짐 현상을 최소화할 수 있어 고단 적층 확장에 유리하다.
실제 이번 제품은 12단임에도 기존 8단과 동일한 높이로 만들었다. 삼성전자는 NCF 소재 두께를 지속적으로 낮춰 업계 최소 칩간 간격인 '7마이크로미터(um)'를 구현했다. HBM3 8H 대비 수직 집적도가 20% 이상 향상됐다.
성능과 용량이 개선된 HBM3E 12H를 채택한 서버업체들은 그래픽처리장치(GPU) 사용량이 줄어 총 소유 비용(TCO)을 절감할 수 있을 것으로 기대된다. 서버 시스템에 HBM3E 12H를 적용하면 HBM3 8H와 비교해 평균 34% AI 학습 훈련 속도를 높이는 게 가능하다. 추론의 경우 최대 11.5배 많은 AI 사용자 서비스를 할 수 있다.
■ HBM 공급물량 경쟁사 압도
삼성전자는 HBM3E 12H의 샘플을 주요 고객사들에게 이미 보냈다. 양산 시기는 올 상반기다. 삼성전자가 신제품 개발에 성공하며 차세대 HBM 시장 경쟁에서 주도권을 쥘 분기점을 마련했다는 평가다. SK하이닉스와 마이크론도 HBM3E 개발을 마친 뒤 상반기 양산을 예고한 상태지만 모두 8단 제품이다. 현재까지 12단 제품 개발 성공을 알린 건 삼성전자가 유일하다.
삼성전자의 또 다른 무기는 경쟁사를 압도하는 생산능력이다. 올해 삼성전자는 전년 대비 HBM 공급 물량의 2.5배 이상 확대를 목표로 대규모 설비 투자를 진행 중이다. 수요에 비해 공급이 부족한 HBM 시장에서 안정적 생산능력을 발판 삼아 점유율을 빠르게 늘린다는 계획이다. 키움증권에 따르면 삼성전자의 월 HBM 캐파는 올해 4·4분기 15만~17만장으로, 같은 기간 SK하이닉스(12만~14만장)를 앞설 것으로 예측됐다.
업계 관계자는 "HBM3E 12H는 HBM 시장 점유율을 높이려는 삼성전자의 회심의 카드"라며 "수율(양품 비율) 등 실제 양산 능력 검증 여부가 중요 변수가 될 것"이라고 말했다.
mkchang@fnnews.com 장민권 기자
※ 저작권자 ⓒ 파이낸셜뉴스, 무단전재-재배포 금지